Micro e nanotecnologia/Microtecnologia/Processi successivi/Diffusione
La diffusione termica rappresenta da sempre la più comune tecnica di drogaggio selettivo del silicio, prima dell’avvento dell’impiantazione ionica. Tuttora tale tecnica è utilizzata in alcuni processi. Il metodo di diffusione consiste nel porre gli atomi di drogante sulla superficie o vicino alla superficie del semiconduttore utilizzando sorgenti solide, liquide e gassose Le sorgenti liquide e gassose sono le più comunemente utilizzata. La diffusione vera e propria del drogante, viene attivata lasciando i wafer in forno ad alta temperatura, nel caso del Silicio a temperature tra i 950 °C e 1280 °C, per un tempo opportuno.
Leggi della diffusione
[modifica | modifica sorgente]Il processo di diffusione è descritto in prima approssimazione da due leggi: la prima e la seconda legge di Fick. In un sistema (solido, liquido o gassoso) detta la concentrazione (per unità di volume) di un certo materiale (in questo caso specifico il drogante) esso si muoverà con una velocità media dalle zone con maggiore concentrazione a quelle con minore concentrazione. Posso quindi definire una grandezza che rappresenta il flusso di materiale (cioè una grandezza vettoriale che ha le dimensioni di un inverso di una superficie e di un tempo). La prima legge di Fick stabilisce che vi è una relazione di proporzionalità tra il flusso e gradiente di concentrazione:
è il coefficiente di diffusione che ha per dimensioni di [l2 t-1], in genere viene misurato in cm2s-1. Nel caso dei solidi la costante di diffusione dipende sia dal materiale diffondente (ad esempio fosforo, arsenico, boro) sia dalla matrice in cui diffonde (ad esempio silicio). La costante di diffusione nei solidi segue la legge di Arrhenius:
Dove è una costante. è l'energia di attivazione che varia tra 0,5 e 1,5 eV se il meccanismo di trasporto è attraverso difetti interstiziali, cioè posizioni naturalmente presenti nel reticolo in cui non vi sono atomi. Se invece il meccanismo di trasporto è determinato da mancanza di atomi nelle posizioni del reticolo regolare le cosiddette vacanze, si ha un diverso meccanismo di trasporto caratterizzato da una maggiore energia di attivazione in genere compresa tra 3 e i 5 eV. La misura della variazione con la temperatura della costante di diffusione permette di distinguere molto facilmente i due meccanismi. Ad esempio l'oro e il sodio diffondono attraverso i difetti interstiziali (e hanno una costante di diffusione molto elevata). Mentre il fosforo, il boro e l'arsenico diffondono attraverso le vacanze (con costanti di diffusione di molti ordini di grandezza più piccole di quelle dell'oro.
In particolare la costante di diffusione del fosforo nel silicio a 1100 °C vale . Mentre quella dell'arsenico o del boro vale alla stessa temperatura .
Nel caso unidimensionale la prima equazione di Fick diviene:
Essendo negativo ed essendo il segno della relazione negativo segue che il flusso di materia è positivo andando dalle zone di maggiore concentrazione a quella di minore concentrazione.
La seconda legge di Fick non è altro che la conservazione della materia in forma locale:
Combinando la prima e seconda legge di Fick si ha l'equazione della diffusione:
La soluzione n(r,t) di questa equazione differenziale al II ordine dipende dalle condizioni al contorno.
Da un punto di vista pratico, in genere si vuole drogare selettivamente alcune regioni del wafer e non altre adiacenti. La regione da drogare viene selezionata utilizzando una maschera o di photoresist o di un materiale che impedisca la diffusione del drogante. Una volta raggiunta la concentrazione desiderata, è sufficiente abbassare la temperatura dei wafer, estraendoli dal forno, infatti grazie alla forte dipendenza dalla temperatura la diffusione si blocca rapidamente.
Processi di diffusione
[modifica | modifica sorgente]I processi di diffusione possono avvenire con diverse modalità e questo determina diverse condizioni al contorno.
Diffusione drive-in
[modifica | modifica sorgente]Tale metodo più tradizionale prevede due fasi fondamentali:


- predeposizione (usualmente abbreviata in predep), cioè introduzione della dose desiderata di drogante, dove la dose, che dipende dalla concentrazione di drogante, è il numero di atomi di drogante per cm2.
- diffusione, in cui gli atomi di drogante, introdotti durante la predeposizione, vengono diffusi all'interno del semiconduttore in modo da ottenere i profili di concentrazione previsti nel progetto.
In questo caso la quantità di materiale drogante è fissata no (dalla quantità deposta inizialmente) e inoltre n(∞,t)=0. In questo caso la soluzione dell'equazione della diffusione è nel caso unidimensionale una Gaussiana:
La lunghezza viene detta lunghezza di diffusione, e fornisce la scala spaziale di estensione del drogante, non solo in questa tecnica specifica.
In particolare sulla superficie (x=0) la concentrazione diminuisce con il tempo con la legge:
Diffusione a concentrazione superficiale costante
[modifica | modifica sorgente]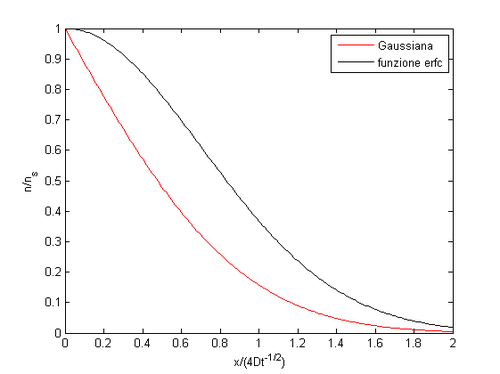
In questo caso non vi sono due fasi separate. Durante il processo di diffusione viene continuamente immesso nuovo drogante sulla superficie in fase gassosa. Il materiale contenente il drogante proviene da un liquido, ad esempio il fosforo è contenuto ossicloruro di Fosforo (POCl3). I drogante sotto forma di composto viene trasportato da un gas che viene soffiato dentro al liquido. Il gas carico del vapore viene diluito in maniera opportuna. La concentrazione di drogante alla superficie del semiconduttore rimane costante nel tempo durante la diffusione: n(0,t)=ns e inoltre n(∞,t)=0. La soluzione dell'equazione della diffusione in questo caso è:
Dove erfc è la la funzione complementare degli errori, una funzione mostrata in figura raffrontata con la gaussiana. Vi è da aggiungere che per la concentrazione diminuisce praticamente linearmente con la distanza dalla superficie. Come si vede nella figura a fianco.
La tecnica a concentrazione costante permette una più rapida realizzazione e un migliore controllo del drogaggio.
Effetti indesiderati
[modifica | modifica sorgente]Nel processo di diffusione il drogante si espande sia in direzione verticale che orizzontale (si avranno atomi di drogante anche al di sotto della zona inizialmente coperta dalla maschera di resist). La concentrazione del drogante diminuisce gradualmente mano a mano che ci si allontana dalla superficie su cui è stata fatta la predeposizione, in generale, l'estensione laterale della zona diffusa è circa l'80% rispetto alla profondità di diffusione in verticale. Il grado di diffusione del drogante aumenta all'aumentare della temperatura. L'energia necessaria alla diffusione, infatti, è proprio fornita dalla temperatura.
Se gli atomi droganti si diffondono anche nelle aree non volute è chiaro che si trovano in contatto superficiale con le superfici di , pertanto risulta necessario un monitoraggio della diffusione di drogante all'interno dello strato isolante. Il comportamento è strettamente dipendente dal coefficiente di aggregazione Se K>1 non si verificano iniezioni di drogante nel , anzi gli atomi droganti si addensano nella superficie dell'isolante. Per valori di K<1 gli atomi droganti tendono ad inserirsi nell'ossido e di conseguenza diminuisce la concentrazione di drogante nella zona di semiconduttore vicina allo strato di ossido.
Bibliografia
[modifica | modifica sorgente]- (EN) Marc J. Madou Fundamental of Microfabrication, 202, 2ª ed., CRC, ISBN 0-8493-0826-7.





















